
【2025年8月1日,德国慕尼黑讯】全球功率系统和物联网领域的半导体领导者英飞凌科技股份公司(FSE代码:IFX / OTCQX代码:IFNNY)近日推出了采用顶部散热(TSC)Q-DPAK封装的CoolSiC™ MOSFET 1200 V G2。这款新型半导体器件能够提供更加出色的热性能、系统效率和功率密度,专为应对工业应用的高性能和高可靠性要求而设计,例如电动汽车充电机、光伏逆变器、不间断电源、电机驱动和固态断路器等。
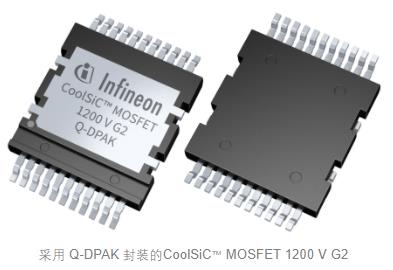
这款CoolSiC 1200 V G2所采用的技术相较于上一代产品有显著的提升,可在导通电阻(Rds(on))相同的情况下,开关损耗降低达25%,系统效率提升0.1%。基于英飞凌先进的.XT扩散焊技术,G2系列产品的热阻相较于G1系列降低15%以上,MOSFET温度也降低了11%。凭借4 mΩ至78 mΩ的出色导通电阻和丰富的产品组合,设计人员能够灵活使用,提高系统性能,满足目标应用需求。此外,新技术支持在高达200°C结温(Tvj)下的过载运行,并具备出色的抗寄生导通能力,确保在动态且严苛的工况下实现可靠运行。
英飞凌CoolSiC MOSFET 1200 V G2提供单开关和双半桥两种Q-DPAK封装。两种型号均属于英飞凌更广泛的X-DPAK顶部散热平台。所有顶部散热(TSC)版本(包括 Q-DPAK 和 TOLT)的封装厚度统一为2.3 mm,具备高度的设计灵活性,使客户能够在单一散热器组件下灵活扩展和组合不同产品。这种设计灵活性简化了先进功率系统的开发,便于客户根据需求定制和扩展其解决方案。
Q-DPAK封装通过实现器件顶部与散热器之间的直接热传导,显著提升散热性能。与传统底部散热封装相比,这种直接热传导路径能够显著提高热传导效率,使系统设计更加紧凑。此外,Q-DPAK封装的布局设计大幅减少了寄生电感,对提高开关速度至关重要,有助于提升系统效率,并降低电压过冲风险。 。该封装由于占用空间小,适用于紧凑的系统设计,其与自动化装配流程的兼容性简化了制造过程,确保了成本效益和可扩展性。
供货情况
采用Q-DPAK单开关和双半桥封装的CoolSiC™ MOSFET 1200 V G2现已上市。
