
0 引言
根据摩尔定律,在一个芯片上集成的晶体管的数目将随时间按指数规律增长。嵌入式存储器SRAM也不例外,正在按这样的速度发展[1-2]。SRAM主要应用于片上系统(System on Chip,SoC),随着SoC的不断发展,对嵌入式SRAM提出了大容量、低成本的需求,从而刺激了高密度SRAM存储器的研发。同时,快速发展的CMOS工艺为存储器集成度的增加提供了实现条件。SRAM存储器的这种高密度发展趋势影响着其设计复杂度,在SRAM设计时需要综合考虑高稳定度、低功耗、高速等性能特点[3]。
本文中,设计不同结构的SRAM存储单元,提供相同的供电电压VDD,分析和比较它们在不同工作状态下的稳定特性。
存储单元中相互独立的晶体管特性是影响SRAM工作性能的重要因素[4]。通常认为,对SRAM起主要影响作用的特性包括晶体管阈值电压Vth和沟道长度L等[5-6]。在分析6T、4T 结构的SRAM工作稳定性时,使用多次蒙特卡洛仿真来考虑晶体管特性的影响,比较存储单元在不同工作状态下的噪声容限均值mean、标准方差sigma和mean/sigma值的大小。所以,在本文中分析SRAM稳定性问题时,根据存储单元的不同工作状态区别分析,包括数据保持状态的噪声容限(Retention Noise Margin,ReNM)、读工作状态的噪声容限(Read Static Noise Margin,RSNM)和写操作状态的容限(Write Margin,WM)[7]。
1 4T SRAM存储单元结构
新型的4T SRAM 存储单元[8-9]由两个PMOS和两个NMOS分别作为上拉器件和传输器件构成。与传统6T SRAM相比,4T SRAM减少了两个下拉器件,即驱动器件。
这种无驱动的4T SRAM在晶体管的类型选取时,上拉器件选用高阈值电压(High-Threshold Value,HVT) 的PMOS晶体管,传输器件选用低阈值电压(Low-Threshold Value,LVT) 的NMOS晶体管[10]。
图1所示为传统6T和新型4T SRAM存储单元版图。经过归一化处理,PMETAL表示单元宽度。可以得出,相比6T SRAM,4T SRAM面积减小了20%。

2 新型4T SRAM的理论分析及建模
2.1 数据保持Retention
图2所示为数据保持工作状态下4T SRAM的工作原理示意图。

双阈值4T结构SRAM在WL低电平条件下保持内部节点存储的数据,然而因为不同内部节点表现出不同的稳定特性,所以称为亚稳态存储单元[11]。这种4T SRAM一侧内部节点通过上拉晶体管稳定地连接到VDD称为静态节点Static Node(QB),而另一侧的内部节点由于容易发生数据翻转和波动称为动态节点Dynamic Node(Q)。动态节点Q的理想工作状态是持续放电,维持数据不发生变化。因此,在数据保持状态,位线Bitline(BL、BLX)接地。
同时,根据不同阈值电压的MOS晶体管具有不同的亚阈值区电流,即漏电流IOFF:

其中,W/L为晶体管的宽长比,Vt为阈值电压,S为亚阈值区摆幅[12]。
通过使用HVT的PMOS作为上拉器件,使用LVT的NMOS作为传输器件,来保证漏电流IOFF_M3远大于IOFF_M1,实现动态节点的‘0’数据保持。
针对这种新型无驱动4T SRAM结构,也可以通过改变晶体管宽长比来调整漏电流,但这种方式不仅会带来额外的存储单元面积损失,得到的漏电流差也并不如通过调整晶体管阈值电压的方式效果明显。所以新型4T SRAM设计使用不同阈值电压的晶体管来保持数据。
2.2 数据读取Read
图3所示为4T SRAM在数据读取工作状态。

4T SRAM读工作前,BL/BLX预放电至GND。WL高电平有效后,4T SRAM的存‘1’内部节点通过BLX放电,BLX电压上升,与BL产生电压差,这个电压差被送到灵敏放大单元,即可读出存储单元存储的数据。
在数据读取工作时,BL/BLX预放电,当WL开启后,存‘1’侧上拉管M2与传输管M4同时打开,通路上的电流即为读电流Read Current。在当前的数据读取工作状态,M2工作在线性区,M4工作在饱和区。如式(2)、式(3)[13]所示,M2上的导通电流Ion_p给QB节点写‘1’,M4上的导通电流Ion_n给QB节点写‘0’,可能使QB节点数据发生反转,导致读紊乱错误(read disturbance)。

为增强4T SRAM的读稳定性,引入读辅助电路read assist(RA)[14-15]。本文中选用的读辅助电路方案:(1)降低字线电压(Word Line Under Drive,WLUD);(2)提升供电电压(VDD Boost,VDDB),提供给上拉器件的源极一个高于VDD的电压,即增大了上拉器件的导通电流和工作速度。同时,上拉器件的衬底应与源极保持相同电压,保证没有衬底偏置效应的影响。
2.3 数据写入Write
图4所示为4T SRAM在数据写入工作状态。减少下拉器件有助于4T SRAM的写操作。这是由于4T结构存储单元的亚稳态特性导致的,存‘1’端的内部节点为静态节点,存‘0’端的内部节点为动态节点。这使得存‘0’端的动态节点较易受到工作状态影响而发生翻转,进而改变静态节点的数据,从而完成4T存储单元的写操作。
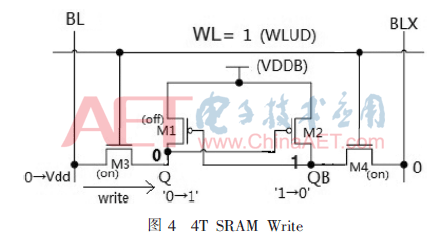
在存储单元写入数据时,将连接存‘0’端内部节点Q的位线置高VDD,使用快速的LVT晶体管作为传输器件,相对较慢的HVT晶体管作为上拉器件,满足连接Q的传输晶体管M3工作电流Ion_n大于连接QB点的上拉晶体管M2工作电流Ion_p,即存储单元易将数据‘0’写为‘1’。
以上两点使得4T结构存储单元具有较强的写能力和较快的写工作时间。
于是对于6T和4T SRAM的写容量Write Margin(WM)定义如式(4)、式(5)所示。

3 仿真结果分析
通常存储单元设计需要在单元面积、速度、功耗、良率之间进行综合考虑、折中取舍。本文针对55 nm CMOS工艺下的传统6T和双阈值4T SRAM,考虑SRAM稳定特性与供电电压的问题,进行多次蒙特卡洛仿真。经过数据归一化处理,结果如表1所示。

4T SRAM数据保持稳定性ReNM相对较差,与6T SRAM相比降低了37.67%。4T SRAM在增加读辅助电路后,数据读取工作的稳定性RSNM显著提高,根据VDDB和WLUD的不同,稳定性提高不同。考虑CMOS工艺最高供电电压VDDB和SRAM读工作速度限制的最低WLUD,4T SRAM的读稳定性可提高110%。新型4T SRAM具有很强的写能力WM,写容限提高183%。很强的写能力,也进一步说明了它的亚稳态特性,与传统6T SRAM相比,减少两个作为驱动的下拉晶体管,更容易受到周围环境的影响,降低了数据保持稳定性。而双阈值晶体管的器件选择,进一步增强了新型4T SRAM的数据写能力。
4 结论
本文提出了一种新型双阈值4T SRAM存储单元,在55 nm CMOS工艺下,与传统6T SRAM相比,实现了版图单元面积减小20%,同时具有较好的工作稳定性和读写速度。本次设计的关键在于使用漏电少的HVT作为上拉晶体管,速度快的LVT作为传输晶体管。这种双阈值的设计是实现数据保持工作状态稳定性的关键,同时,有助于存储单元进行数据写操作。对于读稳定性问题,通过读辅助电路实现有效改善。对新型4T SRAM的不断研究,有助于未来高密度、低功耗的SRAM设计发展。
参考文献
[1] DU X G,MUKHERJEE N,CHENG W T,et al.Full-speed field-programmable memory BIST architecture[C].IEEE International Conference on Test,2005,Austin,TX,2005.
[2] KUMAR A.SRAM cell design with minimum number of transistor[C].2014 Recent Advances in Engineering and Computational Sciences(RAECS),Chandigarh,2014:1-3.
[3] SONG T,RIM W,JUNG J,et al.A 14 nm FinFET 128 Mb 6T SRAM with VMIN-enhancement techniques for low-power applications,2014 IEEE International Solid-State Circuits Conference Digest of Technical Papers(ISSCC),San Francisco,CA,2014:232-233.
[4] BURNETT D,ERINGTON K,SUBRAMANIAN C,et al.Implications of fundamental threshold voltage variations for high-density SRAM and logic circuits[C].Proceedings of 1994 VLSI Technology Symposium,Honolulu,HI,USA,1994:15-16.
[5] LIN H S,HUANG V.Investigation of thermal budget impact on core CMOS SRAM device in an embedded Flash technology[C].2009 16th IEEE International Symposium on the Physical and Failure Analysis of Integrated Circuits,Suzhou,Jiangsu,2009:54-58.
[6] TANG X G,DE V K,MEINDL J D.Intrinsic MOSFET parameter fluctuations due to random dopant placement[J].IEEE Transactions on Very Large Scale Integration(VLSI) Systems,1997,5(4):369-376.
[7] BHAVNAGARWALA A J,TANG X G,MEINDL J D.The impact of intrinsic device fluctuations on CMOS SRAM cell stability[J].IEEE Journal of Solid-State Circuits,2001,36(4):658-665.
[8] SINGH W,KUMAR G A.Design of 6T,5T and 4T SRAM cell on various performance metrics[C].2015 2nd International Conference on Computing for Sustainable Global Development(INDIACom),New Delhi,2015:899-904.
[9] BOUMCHEDDA R,NOEL J P,BIRAUD B,et al.High-density 4T SRAM bitcell in 14 nm 3-D cool cube technology exploiting assist techniques[J].IEEE Transactions on Very Large Scale Integration(VLSI) Systems,2017,25(8):2296-2306.
[10] BROCARD M,BOUMCHEDDA R,NOEL J P,et al.High density SRAM bitcell architecture in 3D sequential Cool-Cube 14 nm technology[C].2016 IEEE SOI-3D-Subthreshold Microelectronics Technology Unified Conference(S3S),Burlingame,CA,2016:1-3.
[11] SHAFAEI A,PEDRAM M.Energy-efficient cache memories using a dual-Vt 4T SRAM cell with read-assist techniques[C].2016 Design, Automation & Test in Europe Conference & Exhibition(DATE),Dresden,2016:457-462.
[12] GHANI T,ARMSTRONG M,AUTH C,et al.A 90 nm high volume manufacturing logic technology featuring novel 45 nm gate length strained silicon CMOS transistors[C].IEEE International Electron Devices Meeting 2003,Washington,DC,USA,2003,11.6.1-11.6.3.
[13] Chen Ming,HU C.Modern semiconductor devices for integrated circuits(IV)[M].北京:电子工业出版社,2012.
[14] ZIMMER B,TOH S O,VO H,et al.SRAM assist techniques for operation in a wide voltage range in 28 nm CMOS[J].IEEE Transactions on Circuits and Systems II:Express Briefs,2012,59(12):853-857.
[15] NAUTIYAL V,et al.Charge recycled low power SRAM with integrated write and read assist, for wearable electronics, designed in 7 nm FinFET[C].2017 IEEE/ACM International Symposium on Low Power Electronics and Design(ISLPED),Taipei,2017:1-6.
作者信息:
张露漩1,乔树山1,2,郝旭丹3
(1.中国科学院大学 微电子学院,北京100029;2.中国科学院微电子研究所,北京100029;
3.中芯国际集成电路制造有限公司,北京100176)